JPhysD编辑优选:先栅工艺提升原位SiNx/AlGaN/GaN MIS-HEMT器件阈值电压稳定性
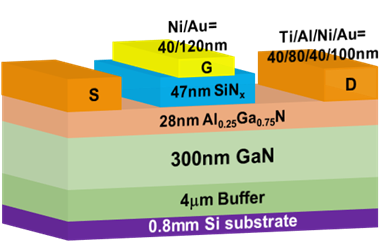
文章介绍
Liang Cheng (程亮), Weizong Xu(徐尉宗), Danfeng Pan(潘丹峰), Huinan Liang(梁辉南), Ronghua Wang(王荣华), Youhua Zhu(朱友华), Fangfang Ren(任芳芳), Dong Zhou (周东), Jiandong Ye(叶建东), Dunjun Chen (陈敦军), Rong Zhang (张荣), Youdou Zheng (郑有炓) and Hai Lu(陆海)
通讯作者:
- 徐尉宗 南京大学
- 陆海 南京大学
首先,基于MOCVD原位生长SiNx介质层的硅基AlGaN/GaN外延结构,本工作分别用先栅工艺和后栅工艺制备了如图1所示的AlGaN/GaN MIS-HEMT器件。
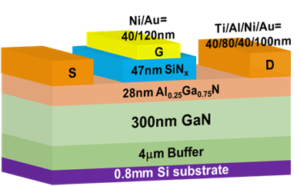

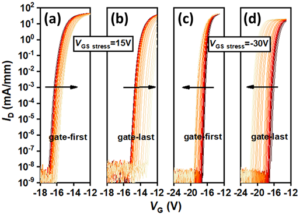
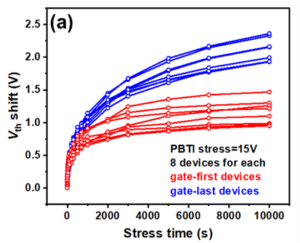
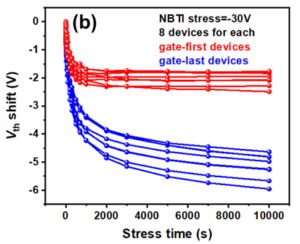
研究背景
氮化镓(GaN)材料由于其禁带宽度大,电子饱和漂移速度高,临界击穿场强高,其功率和射频器件被广泛应用,具有巨大的市场前景。基于AlGaN/GaN异质结的高电子迁移率晶体管(HEMT)是最主要的器件结构。在AlGaN/GaN HEMT的制备中,常在栅极金属和AlGaN之间插入一层栅介质,以增大栅压摆幅,降低栅极漏电。相比于非原位生长的栅介质,MOCVD原位生长的栅介质生长温度更高,介质质量更好。本研究就采用了这样的外延结构。相比于传统的先做源漏电极,后做栅电极的后栅工艺,先做栅极,后做源漏的先栅工艺可以较好地保护栅极界面,并且可以兼容自对准工艺,但后续的高温欧姆退火对栅介质质量提出了严苛的要求。本研究旨在基于原位生长的SiNx栅介质验证先栅工艺在AlGaN/GaN MIS-HEMT制备中的可行性,并揭示其潜在的优势。
作者介绍

程亮,2016年6月本科毕业于华中科技大学光学与电子信息学院,同年进入南京大学电子科学与工程学院陆海教授课题组攻读博士学位,2019年9月至2020年9月在比利时荷语鲁汶大学(KU Leuven)和欧洲微电子研究中心(IMEC)联合培养,研究方向为氮化镓功率和射频器件。
